為什么以及如何將GaN場效應晶體管應用于高效、更高電壓、開關模式電源應用
 31
31
 拍明芯城
拍明芯城
原標題:為什么以及如何將GaN場效應晶體管應用于高效、更高電壓、開關模式電源應用
面對社會和監管要求,電源效率是電子系統的優先事項。特別是,對于從電動汽車 (EV) 到高壓通信和工業基礎設施的各種應用,功率轉換效率和功率密度對于設計成功至關重要。
為了滿足這些要求,開關模式電源系統的設計人員需要從使用傳統的硅(Si)基金屬氧化物場效應晶體管(MOSFET)和絕緣柵雙極晶體管(IGBT)轉變,因為它們正在迅速接近其理論極限。
相反,設計人員需要考慮基于寬帶隙(WBG)材料(如氮化鎵(GaN))的器件。GaN器件的開關速度比硅器件快,可處理更高的電壓和功率水平,對于給定的功率水平,GaN器件要小得多,并且運行效率要高得多。
本文將研究GaN FET的基礎知識,展示它們在開關模式電源電路中相對于傳統硅器件的優勢,并介紹來自 安世半導體,并討論其應用。
氮化鎵場效應管的基礎知識
電源轉換電路中的基本元件是高壓半導體開關。設計人員一直專注于通過以下方式提高這些器件的性能:通過降低導通串聯電阻來降低傳導損耗,通過提高轉換速度來降低開關損耗,以及減少寄生效應。總的來說,這些設計工作在硅MOSFET和IGBT上取得了成功,但隨著這些器件的運行達到其理論極限,改進速度一直在放緩。
因此,在過去幾年中,WBG器件的引入使用了碳化硅(SiC)和GaN,以至于它們已達到批量生產。這些器件提供更高的工作電壓范圍、更快的開關時間和更高的效率。
半導體的帶隙是激發電子以將它們從束縛態釋放到自由態以導電所需的最小能量(表 1)。

表1:區分寬帶隙半導體(如GaN和SiC)與硅的關鍵特性摘要(表來源:Art Pini)
采用寬帶隙半導體制成的器件可以在比硅等傳統半導體材料高得多的電壓、頻率和溫度下工作。更寬的帶隙對于允許器件在更高的溫度下工作尤為重要。耐高溫意味著,在正常條件下,這些設備可以在更高的功率水平下運行。具有更高臨界電場和更高遷移率的WBG半導體具有最低的漏源導通電阻(RDS(ON)),從而減少傳導損耗。
大多數寬帶隙材料還具有高自由電子速度,這使得它們能夠以更高的開關速度工作。
與帶隙為1.12電子伏特(eV)的Si相比,GaN和SiC是化合物半導體,其帶隙分別在3.4 eV和3.3 eV時高出約三倍。這意味著兩者都可以支持更高的電壓和更高的頻率。
GaN更高的電子遷移率使其更適合高性能、高頻應用。GaN 功率 FET 可實現更快的開關速度和更高的工作頻率,從而改善信號控制、具有更高截止頻率的無源濾波器設計和更低的紋波電流。這允許使用更小的電感器、電容器和變壓器,從而減小了整體尺寸和重量。
氮化鎵場效應管被稱為高電子遷移率晶體管(HEMT)。高電子遷移率是FET結構的函數(圖1)。
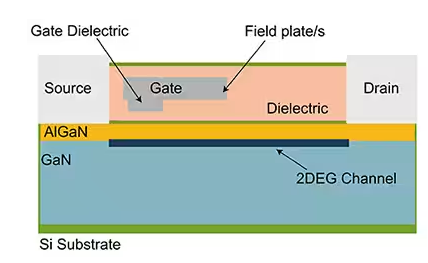
圖 1:基于 Si 襯底的 GaN FET 的橫截面圖。(圖片來源:安世半導體)
GaN FET利用現有的硅CMOS生產設施,使其具有成本效益。在純GaN層生長之前,通過在純GaN層生長之前沉積晶種層以及GaN和氮化鋁鎵(AlGaN)的分級層作為隔離層(圖中未顯示),在Si襯底上形成GaN層。第二個AlGaN層沉積在GaN層的頂部。這建立了壓電極化,在AlGaN(高導電通道)下方立即產生過量的電子。這種過量的電子被稱為二維電子氣體(2DEG)。這個名字反映了這一層中非常高的電子遷移率。
在門下方形成一個耗盡區域。柵極的操作類似于N溝道、增強模式功率硅MOSFET。施加到此設備柵極的正電壓將其打開。
該結構重復多次以形成功率器件。最終結果是一個簡單、優雅、經濟高效的電源開關解決方案。
為了獲得更高電壓的器件,增加了漏極和柵極之間的距離。由于GaN 2DEG的電阻率非常低,因此與硅器件相比,通過增加阻斷電壓能力對電阻的影響要小得多。
GaN FET可以構建為在兩種配置中的任何一種下工作:增強模式或耗盡模式。增強模式 FET 通常關斷,因此必須向柵極施加相對于漏極/源極的正電壓以打開 FET。耗盡模式FET通常導通,因此必須施加相對于漏極/源極的負柵極電壓以關閉FET。耗盡模式FET在電源系統中存在問題,因為在系統上電之前,必須對GaN耗盡模式FET施加負偏置。
解決此問題的一種方法是在級聯電路配置中將低壓硅 FET 與耗盡模式 GaN FET 相結合(圖 2)。
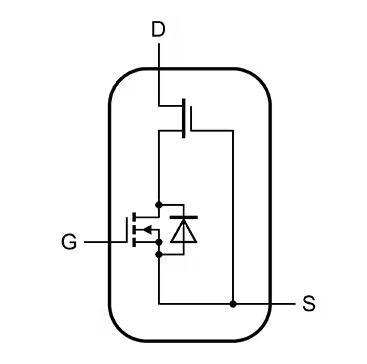
圖 2:采用耗盡模式 GaN FET 的級聯配置的低壓硅 MOSFET 可實現硅柵結構的魯棒性,并改善 GaN 器件的高壓時鐘特性,并且在耗盡模式 GaN FET 的情況下,復合器件在上電時關閉。(圖片來源安世)
級聯電路采用硅 MOSFET 柵極結構,該結構具有與現有 MOSFET 柵極驅動器 IC 匹配的更高柵極驅動限值的優點,并且耗盡模式 GaN FET 在上電時關閉。
GaN FET的主要特性之一是其高效率。這是由于:低串聯電阻,可降低傳導損耗;其更快的開關時間,從而降低了開關損耗;以及較低的反向回收費用,這是其反向回收損失較低的原因。
使用通用的半橋升壓轉換器拓撲,可以比較氮化鎵 FET 和硅 MOSFET 的效率(圖 3)。
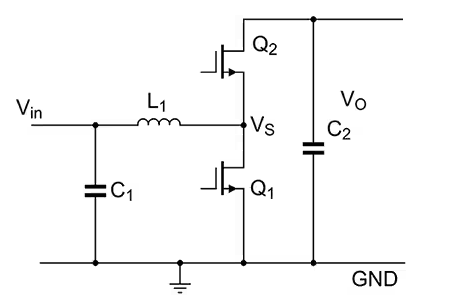
圖 3:所示為半橋升壓轉換器的原理圖,用于通過交換每種類型的晶體管 Q1 和 Q2 來比較 MOSFET 和 GaN FET 的效率。(圖片來源:安世半導體)
升壓轉換器的輸入電壓為 240 伏,輸出為 400 伏,開關頻率為 100 千赫茲 (kHz)。在高達 3500 W 的功率范圍內比較效率和損耗(圖 4)。

圖 4:相同電路中氮化鎵 FET 和 MOSFET 之間的效率和功率損耗比較,顯示了氮化鎵 FET 的優勢。(圖片來源安世)
與MOSFET相比,GaN FET的效率高出約20%,功率損耗降低了約三倍。在 2000 瓦時,MOSFET 中的損耗約為 62 瓦;在氮化鎵場效應管中,它只有19瓦。這意味著冷卻系統可以更小,從而提高升壓轉換器的容積效率。
不太明顯的是,由于GaN FET的最大電壓限制較高,因此測量功率接近3500瓦。因此,GaN FET具有明顯的優勢。
用于更高電壓的氮化鎵入門
針對更高電壓的應用,Nexperia提供兩個650伏氮化鎵FET,即 GAN063-650WSAQ 和 GAN041-650WSBQ.兩者都是通常關斷的N溝道FET。GAN063-650WSAQ 的額定電壓最大漏源電壓為 650 伏,可承受 800 伏的瞬態(脈沖寬度小于一微秒)。它的額定漏極電流為 34.5 安培 (A),25°C 時的功耗為 143 瓦。 漏源導通電阻典型值為50毫歐(mΩ),最大限值為60 mΩ。
GAN041-650WSBQ 具有相同的 650 伏最大漏源電壓額定值和相同的 800 伏瞬態限值。它的不同之處在于它可以處理室溫下 47.2 A 的最大漏極電流和 187 W 的最大功耗。其典型通道電阻為35 mΩ,最大值為41 mΩ。
采用半橋配置的GAN063-650WSAQ的Nexperia參考設計如圖5所示。

圖 5:使用 GAN063-650WSA GaN FET 的半橋功率級的推薦設計。原理圖僅顯示FET驅動器和半橋輸出級以及相關元件。(圖片來源:安世半導體)
原理圖顯示了Si8230高/低雙通道隔離柵極驅動器,用于驅動GaN FET的柵極。柵極驅動器的輸出通過30 Ω柵極電阻連接到柵極,這是所有GaN器件所必需的。柵極電阻控制柵極電容的充電時間,影響動態開關性能。FET漏極和源極之間的R-C網絡也有助于控制開關性能。GaN FET 的柵極驅動電平介于 0 和 10 到 12 V 之間。
GaN FET 的高開關速度(通常在 10 至 11 納秒 (ns) 范圍內)需要仔細布局以最小化寄生電感,并使用 RC 緩沖器來抑制由電壓和電流瞬變引起的振鈴。在高壓電源和接地之間的設計中有多個RC緩沖器(R17至19和C33至35)。緩沖器可減少由GaN FET和旁路網絡相互作用引起的振鈴。緩沖器應盡可能靠近高端FET的漏極連接。它們采用表面貼裝電阻器和低有效串聯電阻 (ESR) 陶瓷電容器來實現,以最大限度地降低引線電感。
R形成的組件網絡4, D1, C12和 C13 是用于高端柵極驅動器的自舉電源。D1 應該是快速、低電容二極管,因為它的結電容會導致開關損耗。R4 限制浪涌充電電流;10 到 15 范圍內的值Ω效果很好。
結論
從電動汽車到通信和工業基礎設施,對更高功率轉換效率和功率密度的需求需要從傳統的硅結構轉變。如圖所示,GaN FET通過提供更高的工作電壓、更快的開關時間和更高的效率,為下一代設計提供了前進的方向。現成的組件(在某些情況下由參考設計支持)可幫助設計人員快速啟動和運行項目。
責任編輯:David
【免責聲明】
1、本文內容、數據、圖表等來源于網絡引用或其他公開資料,版權歸屬原作者、原發表出處。若版權所有方對本文的引用持有異議,請聯系拍明芯城(marketing@iczoom.com),本方將及時處理。
2、本文的引用僅供讀者交流學習使用,不涉及商業目的。
3、本文內容僅代表作者觀點,拍明芯城不對內容的準確性、可靠性或完整性提供明示或暗示的保證。讀者閱讀本文后做出的決定或行為,是基于自主意愿和獨立判斷做出的,請讀者明確相關結果。
4、如需轉載本方擁有版權的文章,請聯系拍明芯城(marketing@iczoom.com)注明“轉載原因”。未經允許私自轉載拍明芯城將保留追究其法律責任的權利。
拍明芯城擁有對此聲明的最終解釋權。




 產品分類
產品分類

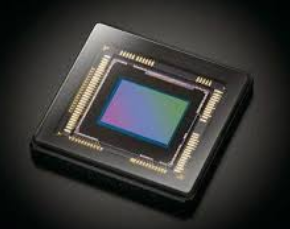






















 2012- 2022 拍明芯城ICZOOM.com 版權所有 客服熱線:400-693-8369 (9:00-18:00)
2012- 2022 拍明芯城ICZOOM.com 版權所有 客服熱線:400-693-8369 (9:00-18:00)


